券商研(生日快乐缩写HBD,hb生日快乐缩写yán)报近期指出(chū),AI领域(yù)对算力的需求(qiú)不(bù)断提高,推(tuī)动了以Chiplet为代表的(de)先进封装技(jì)术的快速发展(zhǎn),提升生日快乐缩写HBD,hb生日快乐缩写高(gāo)性(xìng)能导热材料需求来满足散热需(xū)求;下游终端应用(yòng)领域的发展也带动(dòng)了(le)导(dǎo)热材(cái)料(liào)的(de)需求增加。
导热材料分类(lèi)繁(fán)多(duō),不(bù)同的导热材料有不同的特点和应(yīng)用场景。目前广(guǎng)泛应用(yòng)的导热材(cái)料有合(hé)成(chéng)石墨材料、均热板(VC)、导热填(tián)隙(xì)材料、导热凝胶、导热(rè)硅脂、相变材料等。其中合成(chéng)石墨类主要(yào)是用于均热;导热(rè)填(tián)隙材料、导(dǎo)热凝胶、导(dǎo)热(rè)硅脂和相变材料主要用作(zuò)提升导热能(néng)力;VC可以同(tóng)时起到均热和导热(rè)作(zuò)用。

中(zhōng)信(xìn)证券(quàn)王(wáng)喆等人在(zài)4月26日发布(bù)的研报(bào)中表(biǎo)示,算力需求(qiú)提升,导热(rè)材料(liào)需求有望放量。最先进的(de)NLP模型中参(cān)数的数(shù)量呈指数(shù)级增长,AI大(dà)模型的持续(xù)推出带动(dòng)算力需求(qiú)放(fàng)量(liàng)。面对算力缺(quē)口,Chiplet或成AI芯片“破局”之路。Chiplet技术是提升芯片(piàn)集成度的全新方法(fǎ),尽可能多(duō)在物理距(jù)离短的范围内(nèi)堆叠(dié)大(dà)量(liàng)芯(xīn)片,以使(shǐ)得芯片间的信息传输速度足够快。随着(zhe)更多(duō)芯片的堆叠,不断(duàn)提高封装密度已经成为(wèi)一种趋势。同时,芯片和封装模组的热通量(liàng)也不断増大,显著(zhù)提高(gāo)导热材料需求。
数(shù)据中心的(de)算(suàn)力需求与(yǔ)日(rì)俱增,导(dǎo)热材料需求会提升。根据中国(guó)信通院发布的(de)《中国数据(jù)中心能耗(hào)现(xiàn)状白(bái)皮书》,2021年(nián),散热的(de)能耗占数据中心总能耗(hào)的43%,提高散热能力最为紧迫。随着AI带动(dòng)数(shù)据中心产业进一步(bù)发展,数据中心(xīn)单机柜功率将(jiāng)越来越大(dà),叠加(jiā)数(shù)据中心机架数(shù)的增多,驱动导热材(cái)料需求有望快速增长。

分析(xī)师表(biǎo)示,5G通(tōng)信基(jī)站相(xiāng)比于4G基站功耗更(gèng)大,对于热(rè)管理的要求更(gèng)高。未来5G全球建设会为导(dǎo)热(rè)材料(liào)带来新增量。此(cǐ)外(wài),消(xiāo)费电子在实(shí)现智能化的(de)同(tóng)时逐步向轻薄化、高性能(néng)和多功能(néng)方向发(fā)展。另外,新能源车产(chǎn)销量不断提升,带动导热材料需求(qiú)。
东方证(zhèng)券表示,随着5G商用(yòng)化(huà)基(jī)本普及,导热材料使(shǐ)用领域(yù)更加多元,在(zài)新(xīn)能源汽车(chē)、动力(lì)电(diàn)池、数据中心等领域(yù)运用比例(lì)逐步增加,2019-2022年,5G商用化带(dài)动我(wǒ)国导热(rè)材料市(shì)场规(guī)模年均复合(hé)增长高达28%,并(bìng)有望于(yú)24年达到(dào)186亿元。此外,胶(jiāo)粘剂、电磁屏蔽材料(liào)、OCA光学(xué)胶等各类(lèi)功能材料(liào)市(shì)场规模均在下游(yóu)强(qiáng)劲(jìn)需求下呈(chéng)稳步上升(shēng)之势。

导热材料产业链主要分为原材(cái)料、电磁屏(píng)蔽(bì)材(cái)料、导热器(qì)件、下游终端(duān)用户四个领域(yù)。具体(tǐ)来看,上(shàng)游所涉及的原材料主要集中(zhōng)在高分子树(shù)脂、硅胶块、金属材料及布料等。下游方面,导热材料(liào)通(tōng)常(cháng)需要与一些器件结(jié)合,二(èr)次开发形成导热器件并最(zuì)终应用于消费电池、通信基站(zhàn)、动(dòng)力(lì)电池等领(lǐng)域。分析人士(shì)指出,由于导热(rè)材料(liào)在终端的中的成(chéng)本占比(bǐ)并不高(gāo),但其扮演(yǎn)的角色非常(cháng)重要,因而供(gōng)应商业(yè)绩稳定性好(hǎo)、获利能力稳定。
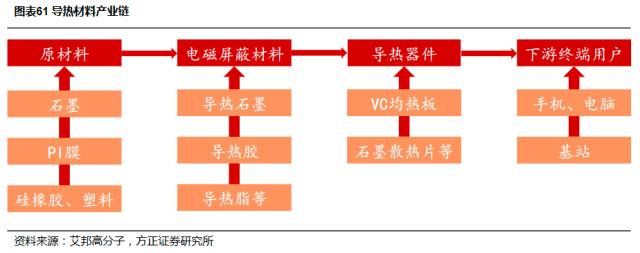
细分(fēn)来看,在石(shí)墨领域有(yǒu)布局的(de)上(shàng)市公司为中石科(kē)技、苏州天脉;TIM厂(chǎng)商有苏州(zhōu)天(tiān)脉、德邦科技、飞荣(róng)达。电磁屏(píng)蔽材料有布局的(de)上市(shì)公司为长(zhǎng)盈精密、飞荣(róng)达、中石科技;导热器件有布局的(de)上市公司为领益智造、飞荣达。




在导热材料领域有新增项目的上市(shì)公司为德邦科技(jì)、天赐材料、回天新材、联瑞新(xīn)材、中石科(kē)技(jì)、碳元科技。


王喆(zhé)表示,AI算力赋(fù)能(néng)叠加下游终端应用升级,预(yù)计2030年(nián)全球导热材料市场空间将达(dá)到 361亿元, 建议关(guān)注两条投资主线:1)先(xiān)进散热材料主(zhǔ)赛道领域,建议(yì)关注具有技术和先发(fā)优势的公司德邦科技、中石科技(jì)、苏州天脉(mài)、富烯科技等。2)目前散热材(cái)料核心材仍然大量依靠进口(kǒu),建议关注突破核心技术,实现(xiàn)本(běn)土(tǔ)替(tì)代(dài)的联瑞新材和瑞(ruì)华泰等。
值得注意的是,业(yè)内人(rén)士表示,我国外导热(rè)材料发展较晚,石墨膜和TIM材(cái)料(liào)的核心原材料我国技术(shù)欠缺,核心原材料绝大部分得依靠进口。
未经允许不得转载:腾众软件科技有限公司 生日快乐缩写HBD,hb生日快乐缩写
 腾众软件科技有限公司
腾众软件科技有限公司 









最新评论
非常不错
测试评论
是吗
真的吗
哇,还是漂亮呢,如果这留言板做的再文艺一些就好了
感觉真的不错啊
妹子好漂亮。。。。。。
呵呵,可以好好意淫了